
 | |
|
|
Главная » Книги и журналы 1 2 3 4 5 6 7 ... 24 дймости тунда рует йПфЬЩое^ час|ю электронов. КритйчеаШ поле, необходимое для во някновеиня эмиссии, ие зависит от профиля распределения концентрации, а напряжение пробоя Ubr, часто обозначаемое как зииеровское иапряжение^(/г. пропорционально удельному сопротивлению полупроводника. Хотя приведенные здесь значения критического электрического поля превышают соответствующие величины, прн которых обычно начинается ударная ионизация, но, несмотря на это, в узких запирающих слоях ударная ионизация не возникает, так как носители при прохождении гонкой области объемного заряда не могут получить от поля необходимую для ударной ионизации пороговую энергию. Истинная полевая эмиссия возникает в иизкоомных, узких р-п переходах в диапазоне вышеприведенных напряжений. Явление пробоя в относительно толстых запирающих слоях прн относительно малых иапряжеииостях электрического поля объясняется преимущественно эффектом ударной ионизации. Именно этот механизм пробоя имеет место в транзисторах. Вольтамперная характеристика в области зииеровского пробоя была исследована с различных точек зрения. Приближенное выражение, получаемое в теории полевой эмиссии, имеет вид AUpE ехр Р (1.86) где V - напряжение на р-п переходе; 1; Л - константа, зависящая от температуры решетки; £ -напряженность электрического поля в области пространственного заряда: ql~3. Произведение AUp определяет число носителей заряда, которые в единицу времеии могли бы в принципе туниелировать; е~ представляет собой теоретическое выражение .вероятности туниелнрова-иия этих носителей. Температурная зависимость вольт-амперной характеристики в области зииеровского пробоя определяется преимущественно температурной зависимостью ширины запрещенной зоны. Эта величина уменьшается с ростом температуры, следовательно, вероятность туннелирова-ння увеличивается. При одной и той же вероятности туннелнрования, т. е. при одном и том же туннельном токе, зииеровское напряжение уменьшается с ростом температуры, а температурный коэффициент напряжения зинеровского пробоя имеет отрицательный знак, т.е. ткн и <0 /=const Это СВОЙСТВО является одним из существенных признаков различия лавинного (ТКН>0) и туннельного .видов пробоя. Величина пробивного напряжения, а также наличие 1или отсутствие эффекта размножения носителей  г - .1. ттштт чия лавинного я туннельного виДов пробоя. Зинеровский и лавниный эффект используется в диодах, которые не всегда обоснованно называются зинерОвскимн. Если пробивное напряжение лежит в области зинеровского пробоя (например, для Si ниже 4,5В), то такое название справедливо. Более высокие значения напряжений пробоя указывают иа наличие лавинного эффекта, и соответствеиио такие диоды целесообразно называть лавинными. Пробой вследствие полевой эмиссии может развиваться неравномерно по всему запирающему слою, если в нем имеются дефекты структуры, т. е. неровности в запирающем слое, дефекты кристалла, краевые дефекты, включения окислов и т. д. Дефекты ведут к локальному повышению иапряжеиности поля и тем самым стимулируют развитие пробоя в этих участках перехода. Принципиальный ход вольтамперной характеристики в этих случаях пе изменяется, потому что и в бездефектном запирающем слое пробой происходит неравномерно с микроскопической точки зрения; более того, в запирающем слое образуется большое количество параллельно действующих каналов, которые пропускают очень малые токи. Не исключено, что эти каналы появляются из-за наличия колебаний в распределении примесей, что, в свою очередь, ведет к иеодиородностям в распределении электрического поля. С ростом поли число таких эмиттирующих центров возрастает (что подтверждено наблюдениями эмиссии света в каналах), но пропускная способность каналов ограничивается их сопротивлениями. Шокли создал модель развития пробоя и рассчитал характеристику в области пробоя, исходя из представления о том, что эмиттирующие каналы образуются вследствие наличия колебаний в расиределсини примесей. Расчет показал эксионснциальный характер нарастания числа парал-ле.пдю догствуюнхих каналов с ростом напряжения. Лавинный пробой. Если напряжение пробоя превышает в кремниевых переходах 4-8 В, а в германиевых 4-20 В, то определяющим механизмом пробоя является лавинное размножение носителей заряда. Этот процесс протекает в запирающем слое ио аналогии с процессом образования газового разряда, так что модель, применяемая для объяснения процесса ударной ионизации в газах, в принципе может быть перенесена и на явление лавинного размножения в запирающем слое. Прн развитии лавинного пробоя в таких переходах носители заряда, образующие ток насыщения, в сильном электрическом поле достигают энергии, достаточной для того, чтобы вследствие ударной ионизации образовать новую пару носителей заряда, т. е. при достижении напряжения пробоя начинается лавинообразное умножение количества носителей в области пространственного заряда, которое дает возможность увеличиваться току пробоя до тех пор, пока пространственный заряд подвижных носи- 6-1323 81 Ч-, (< л - ТелеА не изМеййт riaiifieitHoctb поЛй й аПирайгЦёМ слое и не ограничит темп размножения носителей заряда. Так как для развития процесса ударной ионизации необходимо, чтобы носители заряда имели определенную длину свободного пробега, то это явление происходит преимущественно в широких р-п переходах (рис. 1.14).  Злектронь Рис. 1.14. Модель для объяснения процесса лавинного пробоя в р-п переходе: Zl. - число электронов, втекающих в единицу времени в запирающий слой через границу х=1р (2о - число неосновных носителей); Z - число электронов, вытекающих в единицу времени нз запирающего слоя через границу = {7. - число основных носителей).  -у В запертом переходе возникающие электронно-дырочные пары поддерживают токи основных носителей в нейтральных областях. Возникает устойчивое лавинообра-зова иие и умножение тока (дополнительные эффекты, связанные с изменением пространственного заряда, здесь не учитываются). Количественной мерой размножения носителе!! заряда является скорость ударной ионизации ai{E) (резко зависящая от напряженности электрического поля), т. е. число пар носителей, образованных одним носителем на отрезке dx, отнесенное к общему числу всех носителей: (1.87) Если принять упрощающее (но не обязательное) предположение о равенстве скоростей ионизации электронов и дырок, то прирост количества электронов в единицу времени dz на отрезке запирающего слоя между х и x + dx будет равен {ZQZi)aidxA-Z2aidx = zaidx, (1.88) так как имеющиеся в точке х=/р Zq электронов образуют в точке X за счет ионизации Zi пар носителей. Точно также дырки на отрезке между {x-\-dx) и In образуют Z2 электронов. В точке xln появляется в результате Z электронов: z=ZQ-\-Zi+Zz. (1.89) 4 - -к; Г Общее число электронов, дополнительно образующихся в единицу времени в запирающем слое между 1р и /п, равно (1.90) р -р Отношение общего количества электронов z, вытекающих в единицу времени из запирающего слоя, к числу исходных го электронов, т. е. коэффициент умножения М, будет равно М о п 1 -? (/ -/p)at(£M3Kc) , (1.91) где т - корректирующий множитель; - усредненная скорость ударной ионизации; £макс - максимальная напряженность электрического поля в запирающем слое. Связь \[сжду коэффициентом умиоже1!ия и скоростью иотзации а, (Б) была рассчпгапа для различных случаев. В [Сражение, содержа uice ко])ректрую1[ип [ [иoжцтeль т (!.9!), дает возможность избежать интегрирования функции fx, {Е), если принять некоторую усредне1П!ую скорость ионпза[1ИИ, относяи1уюся к области максимального электрического поля (макс). Для корректиру10[[1Сго множителя при этом дается зиаче[1ие /п^0,32. Скорость ударной ионизации а,- рассчить1валась в ряде теорий, часто опира[ОЩ[[хся на модели, подобр[ые моделям [)азвития пробоя в газах. Так, рассматривалась модель с однородным нолем в предположении об изотропном распределении скоростей торячих носителей заряда в однородном поле; далее, было учтено влияние средней длины свободного пробега, KOTopoii обладают носители заряда до [1ачала ударной ионизации иа процесс размножения; было учтено также рассеяиЯе энергии вследствие столкновений и, наконец, в об-ш.ей форме рассмотрен процесс ударной ионизации при учете изотропного характера распределения скоростей и при учете иглообразного характера распределения скоростей в направлении электрического лоля *К Так как число носителей -заряда, переходящих в единицу времени через границы запирающего слоя, пропор- Эти Предположения приводят к зависимостям ai{E), плохо Согласующимся с экспериментом. В наиболее общем виде эта проблема рассмотрена Л. В. Келдышем. Им показано, что в относительно слабых полях О,- растет пропорционально ехр(-&/Е), а в сильных полях - пропорционально ехр(-а/£2). - Прим. перев. ционально току, то коэффициент умножения М можнЬ непосредственно применить к току  (1.92) причем ток / не включает в себя компонента тока смещения. Определение скорости ионизации в готовом полупроводниковом приборе связано с большими трудностями, поэтому для упрощения дальнейших расчетов обычно пользуются эмпирической формулой Af= .1. . . > (1.93) и и В которую иеиосредствеино входит пробивное нап^яже- пие Umi 1000  Рис. I.I5. Зависимость напряжения пробоя от концентрации примеси (AD, N а) для сплавных германиевых переходов.
Рнс. Мб. Зависимость напряже иия пробоя от удельного сонро тивлення полупроводника. -- - германиевый р+-л переход; ----кремниевый +-р переход. Для коэффициента п дается ряд значений, относящихся к высокоомным полупроводникам: кремний /?-тип 1,5 я-тип 3,5 2. 4; германий /7-тип 4н-7, П'ТШ 3, причем значение п не зависит от температуры и определяется только материалом высокоомной области перехода (рис. 1.15).- Заметим^ что ийвгда в литературе ука*    зываЮтся ¥акже значения п, меныййё, ч лице. Напряжение пробоя в резких переходах зависит только от удельного сопротивления высокоомной области. Так, для расчета Ubr используются формулы и 40 р и 83 р 0.75 Р 0.61 п С высоко-[Ом-см]); С высоко- - резкий переход в кремнии омной /7-областью (,[В], р - резкий переход в германии омной /г-областью. На рис. 1.16 показаны графики этих зависимостей, построенные в двойном логарифмическом масштабе. Кроме того, пробивное напряжение сильно зависит от геометрии р-п перехода, особенно от радиуса кривизны области объемного заряда в резких переходах. Для линейных переходов влияние радиуса кривизны меньше. Планарные переходы из-за наличия участков с малым радиусом кривизны имеют пробивные напряжения, меньшие, чем у плоских переходов. В общем случае пробивные напряжения у цилиндрических и сферических р-п переходов меньше, чем у плоских. В приведенных выше рассуждениях о пробое ирене-брегалось пространственным зарядом инжектированных носителей, а также зарядом носителей, образованных за счет ударной ионизации, что допустимо при напряжениях, меньших Ubr, по не всегда допустимо в области развитого пробоя. Это подтверждается результатами измерения шумов, которые указывают иа наличие токовых шумов в области размножения носителей заряда, что непосредственно связано с пространственным зарядом подвижных носителей. В транзисторе лавинный пробой происходит или менее равномерно но площади коллекторного рающего слоя, что подтверждается результатами рений электролюминесценции. Во всяком случае это справедливо при таких плотностях тока, когда еще ие возникает заметного влияния подвижных носителей заряда иа распределение п6ля:,Наоборот, в диодах пробой происходит часто неравномерно по площади запирающего слоя Больше того, в запирающем слое имеются более заии-изме- Это противопоставление транзисторов и диодов не следует принимать как принципиальное. Если такое соотношение и имеет место, то оио определяется главным образом качеством технологи-ческцх процессов изготовления приборов - Прим, перев. V4-- - .- области, при прохождении которых носители достигают более высоких энергий, чем в других участках, где имеет место, следовательно, более высокая скорость лавинного размножения. С большой вероятностью эти локальные области с повышенной напряженностью поля 1идентифи-цируются с дефектами в р-п переходе: внешние края запирающего слоя, дислокации, границы зерен, неровности и включения инородных веществ. В местах этих дефектов при больших запирающих напряжениях развивается пробой за счет микроплазм, которые обладают нестабильностью. Однако еще до появления микроплазм в определенных местах запирающего слоя при высоких скоростях ионизации носителей можно обнаружить отклонение от зависимости M = f{U) (1.93), что приписывается эффектам, связанным с пространственным зарядом подвижных носителей, возникающим при больших плотностях тока, так как эти же эффекты были обнаружены в переходах, имеющих самостоятельно действующие каналы ударной ионизации. Для таких случаев уравнение (1.93) несправедливо. многих переходах с больитми проб}И1т-.1ми напряжениями в области пробоя образуются отдельные каиаль! ионизации (микро-плазмы), которые возникают'Преимущественно вблизи дефектов запирающего слоя п при малых пробивных токах включаются и выключаются в беснорядочион последовательности. Такие явления наблюдались при развитии лавинного пробоя в запирающих слоях с малой активной плои1а21ью. Были разработаны модели для объяснения действия таких нестабильно функцио1Ифующих каналов пробоя. Они базируются в конечном счете на том, что должен иметь место механизм обратзюй связи, которьн ! поддерживает самопроизвольный пробой за Счет ударной ио]1Нзаиии. Эта обратная связ], как правило, обусловливается ннжекцисй неосновных носителей в запираюпн!н слой подобно тому, как это имеет место в транзисторе. Обратная связь может б1>1ть обусловлена также оптическом связью, поскольку, как неоднократно наблюдалось, в каналах ударной ионизации эмнттируются кванты света и, таким образом, происходит взаимное влияние на частоту зажигания нестабильно включающихся и выключающихся микроплазменных каналов. Генерация пар носителей заряда в канале пробоя происходит под действием фотонов, появляющихся в соседнем канале. Если в соседних областях может быть генерировано достаточное количество неосновных носителей заряда, то канал пробоя больше не погаснет . В предельных случаях обратная связь может привести даже к разгоранию микроплазм. Факторами, ограничивающими ток в каналах пробоя, являются: пространственный заряд подвижных носителей, сопротивления нейтральных областей и тепловой разогрев решетки, бозиикиовеийе й исчейовенйе канала пройоя п{ойсхоДйФ в f6-чеиие очень короткого промежутка времеии, порядка нескольких десятков пикосекуид. Частотный спектр их беспорядочного включения и выключения регистрируется как шум. Наряду с уже описанными микроплазмами у бездефектных запирающих слоев обнаружены также области развитой ударной ионизации большой площади (макроплазмы), световая эмиссия которых позволяет сделать вывод, что эти области представляют собой много параллельно включенных областей пробоя, которые по .предположению Шокли, связаны с колебаниями концентраций примеси в отдельных участках запирающего слоя. Может случиться, что пробой за счет ударной ионизации в области малых токов происходит в отдельных параллельно действующих каналах (микроплазмах), которые имеют напряжение пробоя меньшее, чем бездефектные участки запирающего слоя с большим пробивным напряжением. Только при высоких напряжениях в пробивной области эти бездефектные участки проводят ток (макроилаз-ма), который превышает ток, обусловленный микроплазмами. Нельзя не упомянуть о том, что оба механизма пробоя - внутренняя полевая эмиссия и ударная ионизация- могут действовать одновременно. Так, было показано, что при пробое за счет внутренней полевой эмиссии может развиваться и ударная ионизация, если носители заряда при нрохожденни запирающего слоя дости-гают пороговой энергии ударной ионизации или, как говорят, носители разогреваются до определенной температуры, которая для кремния равна 1,8 10 К, а для германия 6-10* К. В таких переходах с комбинированным механизмом пробоя температурный коэффициент напряжения пробоя близок к нулю или равен ему. В общем случае явления зинеровского и лавинного пробоя обратимы, пока тепловому разогреву препятствует какое-либо ограничение тока. Диоды подвергаются опасности выхода из строя также в том случае, если пробой развивается неравномерно по площади запирающего слоя. Поэтому в области пробоя допустима работа только таких р-п переходов, которые имеют однородное распределение поля в запирающем слое. - г БЕЗДРЕЙФОВЫЙ ТРАНЗИСТОР. СТАТИЧЕСКИЕ ХАРАКТЕРИСТИКИ После анализа свойств р-п перехода следует обратить внимание на два его важных свойства, имеющих решающее значение для работы транзистора, и рассмотреть взаимодействие двух р-п переходов в р-п-р структуре. 1. При относительно небольшом (и малом по абсолютной величине) увеличении прямого напряжения на р-п переходе можно получить большой градиент концентрации и, следовательно, большой диффузионный ток неосновных носителей, которые, преодолевая достаточно узкий запирающий слой, практически не рекомбиннруя в нем, глубоко диффундируют в нейтральные области (инжекция неосновных носителей). 2. В запирающем направлении р-п переход пропускает чрезвычайно малый ток насыщения, который образуется неосновными носителями, генерируемыми в прилегающих к запирающему слою диффузионных хвостах , а затем в виде дрейфового тока проходящими через запирающий слой. Если неосновные носители образуются вследствие не только тепловой генерации, но и других эффектов (оптическая генерация, зинеровский эффект, внутренний фотоэффект, инжекция), то они вследствие дрейфа также проходят запирающий слой и увеличивают обратный ток р-п перехода. Таким образом, чувствительность обратного тока к неосновным носителям (эффект собирания носителей, экстракция, или коллекция носителей) в сочетании с эффектом инжекции носителей, возникающих в другом переходе, и составляет фундаментальный принцип действия плоскостного транзистора. Вопрос о том, как именно осуществляется инжекция носителей и что является источником эмиссии, становит-  ся уже чисто техническим. В частности, в качестве такого источника можно использовать р-п переход, смещенный в прямом направлении и инжектирующий носители заряда, которые образуют диффузионный хвост . Необходимо лишь обеспечить условие, когда диффузионное пространство прямо смещенного перехода одновременно является областью затягивания (экстракции) носителей второго обратно смещенного перехода iJepeda ча Эмиссия X Коллекция  о  Змиттер Коллектор Область базы Рис. 2.1. Схсмлт1!ческос изображение прииципл действия транзистора: л) качсстпсммос поясистю пзаимпдейстпия дпух связанных р-п поос>н)до11; б) модель трпнзпстора; и U,- толп.ииы злпирающих слоен.  (рис. 2.1). Задача левого диода состоит в том, чтобы обеспечить монипяй диффузионный ток (эмиссия носителей), что требует приложения к переходу малого прямого напряжения. Задача правого диода состоит в том, чтобы собирать как можно больше носителей заряда из числа инжектированных левым диодом, что успешно осуществляется этим диодом благодаря приложению большого запираюи1,его напряжения. Между ООО!! ми переходами дол ж i к:) гун^ествовать H(Mipcpi>nMioe изменение концентрации исоснотпях носителей от места их эмиссии к месту нх коллекции , или, проще говори, от эмиттерного к коллекторному переходу. Оба перехода функционально объединяются благодаря наличию про-.мсжуточного, общего для них диффузионного пространства. Для того чтобы диффузионный ток носителей, выходящих из эмиттерного перехода, достигал коллекторного перехода по возможности без рекомбинационных потерь, ширина этого диффузионного пространства W должна быть значительно меньше диффузионной длины Lp.- W<L,. (2.1) (речь идет о р-п-р транзисторе). Чтобы обеспечить возможность приложения к эмит-терному и коллекторному переходам требуемых напряжений смещения, а также чтобы дать возможность протекать току основных носителей, связанному с рекомбинацией, к диффузионному пространству подключается внешний электрод - так называемый электрод базы. Часто он называется просто базой, а ширина IF -шириной базы. Запирающий слой эмиттера Элеитоод эмиттера Индай 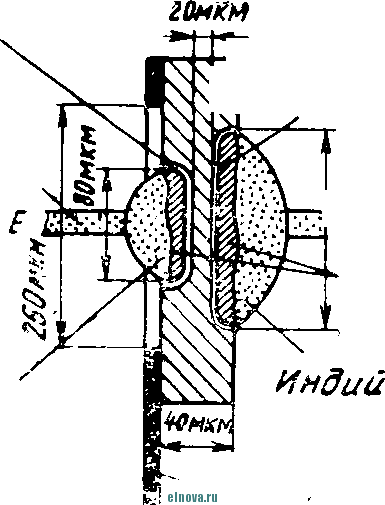 Германий п-тагуа хГ Запипающии слой нолленгГ)ора Элентрод коллектора Рекристаллизовоии^а слои Р'/77 и/7а Рис. 2.2. Схематическая С1руктура сплапиого р-п-р транзистора. Эта структура - mi.iHHApnivcKH симметричная (мпсштпб нп рисунке не соблюден). На рис. 2.2 схематически показана структура такого транзистора. Эта структура образуется при вплавлении с обеих сторон в тонкую (200 мкм) пластинку германия я-типа проводимости индиевых шариков (индий - акцептор!). В процессе вплавлення возникают два почти плоскопараллельпых фронта между расплавом и твердым телом, причем после рекристаллизации образуются две легированные индием области германия /?-типа проводимости (рекристаллизованные слои), разделенные очень узким (порядка нескольких десятков микрон) слоем базы. Запирающие слои эмиттера и базы находятся между рекристаллизованными слоями и исходным д-германием. Подключение транзистора к внешней схеме производится с помощью электродов эмиттера (£), базы (S) и коллектора (С). Здесь схематично рассмотрен процесс создания р-п-р транзистора; аналогичным образом можно было бы проследить и схему создания п-р-п транзистора. Такие транзисторы относятся к типу плоскостных. Их нрин- ций действия обуслойлен. инжекцией неосноЁнУХ носй1е-лей из эмиттера в базу. Большая часть этих носителей после продвижения за счет диффузии через область базы попадает в коллектор. Таким образом, с точки зрения механизма переноса носителей эти транзисторы следовало бы называть диффузионными *>. Так как транзисторы данного типа, названные по принципу их действия бездрейфовыми, технологически обычно изготавливаются методами вплавления (см. гл. 7), то по этому признаку их часто называют сплавными или иногда транзисторами с однородной (гомогенной) базой, поскольку в области базы примесь распределена равномерно. Последнее наименование для данного типа транзисторов, по-видимому, наиболее удачно, поскольку в определенных режимах работы транзистора (высокий уровень инжекции, см. §6.3) в базе кроме диффузионных токов могут протекать и значительные дрейфовые токи. Однако, несмотря на то, что термин бездрейфовый транзистор не всегда полиостью соответствует смыслу физических процессов, в дальнейших главах он сохраняется. Исторически этот транзистор вначале был предсказан (а позже и реализован) Бардином и Браттэиом, после того как Шокли открыл эффект инжекции. В честь Шокли транзисторы, работающие на принципе инжекции, назьн^ают также транзисторами Шокли. Со времени открытия транзистора было накоплено много новых сведсти ) о его работе, а также рсализова1ю много идей но усовершенствованию транзистора. 11оэтому неудивительно, что основные физические свойства транзистора подробно исследованы с различных точек зрения (исход1П>П1 материал, теоретические основы работы, применение). Для простого качественного рассмотрения процессов в транзисторе в рамках исходных предпосылок, сделанных Шокли для р'П перехода (см. § 1.1), структура, изображенная на рис. 2.2, не вполне пригодна. Однако можно упростить эту структуру, оставаясь в рамках условий, близких к реальным, мысленно выделив из нее р-п-р структуру в форме цилиндра с осью, направленной от эмиттера к коллектору (рис. 2.3). Для такого модельного транзистора в первом приближении будет справедливо допущение об одномерном Следует заметить, что в отечественной научно-технической литературе этот термин не принят. Транзисторы данного типа называются бездрейфовыми, поскольку основной механизм переноса носителей в базе не связан с дрейфом. В то же время термин бездрейфовый позволяет устранить путаницу в названии одним и тем же термином - диффузионный - транзисторов различных типов, а именно: транзисторов, в которых ток носителей в базе переносится за счет диффузии, и транзисторов, которые были изготовлены технологическими методами диффузии атомов примеси в исходный полупроводник. - Прим.. перед,  д- .г j Г характере движения йойителей заряда. Однако в противоположность простой модели р-п перехода в данном случае даже при малых плотностях инжектированных носителей нельзя полностью пренебречь сопротивлениями нейтральных областей, препятствующих протеканию тока основных носителей, особенно в области базы. Из рис. 2.2 уже на основе геометрических представлений можно предположить, что между внешней клеммой базы и запирающими слоями действует распределенное сопротивление-сопротивление базы, - и поэтому, напри-
Рнс. 2.3. Схема модельного транзистора, р, которой выделен внутренни)] трапзнстор, а также последовательные гонр()11и!лс11ня CiijiaBa - симвиличсскос изобрг1Жсн11е т[)амзисто1)а. мер, напряжен /е Ui:b, приложенное между электродами эмиттера и базы, не равно напряжению иа за[П1раюн1,см слое эмиттера. Если включить некоторое сосредоизчсипос сопротивление между внешним электродом базы и модельным транзистором, то при этом в нерво.м приближении устраняется трудность, связанная с исобхсдимостью строгого рассмотрения много.мерного характера движения носителей заряда. Модельный транзистор, в которо.м не учитываются последовательные сопротивления, имеет внутренние условные клеммы Е'В'С Строго говоря, эти точки (особенно В') нельзя считать локальными, так как в действительности следует рассматривать пространственно-распределенные сопротивления (особенно это касается сопротивления базы). Между условны.ми клеммами Е^В'С находится так называемый внутренний транзистор (intrinsic transistor). По аналогии с этим термином транзистор, находящийся между точками Е, В н С, обозначают как внешний транзистор (extrinsic transistor). Внутренние напряжения {Ueb и т. д.) являются только удобными величинами, которые 92 следует рассматр-ийать как вспомогательные и которые в окончательных формулах должны быть исключены. Относительно малые по величине последовательные сопротивления эмиттера и коллектора следует учитывать только в особо подчеркиваемых случаях. К сопротивлению базы это замечание относится в меньшей степени, хотя оно в некоторых зависимостях фигурирует, скорее, качественно, чем количественно. В связи с этими замечаниями подчеркивание различия между внутренним и внешним транзистором не всегда необходимо*. Свойства транзистора, связанные с передачей тока от эмиттера к коллектору, в первую очередь определяются процессами в базе. Опуская подробности рассуждений, можно отметить, что одним из характеристических параметров процесса диффузии является пролетное время, определяющее, например, время, за которое импульс инжектированных носителей проходит из эмиттера в коллектор. Процесс диффузии является сравнительно медленным, и поэтому обусловленное им пролетное время имеет нижнюю границу. Существенно более коротких времен можно достигнуть, если в базе создать дополнительное электрическое ноле, ускор5иощсе неосновные носители. Ысли п первом нрнблнжеиип принять, что, например, /длрка за время жизни Тр проходит путь, равны!! Lp, то можно онредслить ее средтою диффузионную скорость как VpLp/xp. Дрс1в|)оиая же скорость по онрсделепию равна Vf)p = [\.pE. Из с[)авнеиия этих скоростей можно получить, что достаточно наличия ноля, pannofo Ц = --1. (2.2) чтобы дырка могла за время Хр продвинуться за счет дрс[и[)а сс скоростью VDp = Vp па расстояние Lp. Так, например, для значениГ! мВ и Lp0,3 мм (типично для германия) расчет дает весьма ма.чос значение /Г==0,82 В/см. Ускоряющее дрейфовое ноле в базе может быть получено за счет неравномерного распределения лримесей в базе либо может возникнуть при высоком уровне инжекции неосновных носителей заряда в базу. В первом случае уже в обесточенном состоянии концентрация основных носителей заряда в базе будет изменяться с координатой подобно тому, как это имеет место в забирающем слое. Благодаря наличию градиента концентрации основных носителей возникает в отечественной научно-технической литературе терминам внутренний и внешний транзистор соответствуют термины теоретическая модель транзистора н реальный транзистор . - Прим. перев. диффузионный ток, а dod(<iflbicy результирующий ток равен нулю, то в базе возникает электрическое поле, обусловливающее по5Гвле-ние дрейфового компонента тока, уравновешивающего диффузионный компонент. Если, например, концентрация доноров уменьшается от эмиттера к коллектору, то диффузионный ток электронов направлен к коллектору, а компенсирующий его дрейфовый - к эмиттеру. В целом же полупроводник 5Твляется нейтральным *\ При слабой инжекцин неосновных носителей, - дырок, - практически не изменяющей равновесное распределение электронов, дырки быстро движутся от эмиттера к коллектору вследствие не только диффузии, но и действия ускоряющего поля. Во втором случае при относительно высоком уровне инжекции неосновных носителей в базу вследствие условия электронентрально-сти в каждой точке базы возрастает и концентрация осиопиых носителей, причем наиболее резко у эмиттера. Как следствие градиента концентрации этих носителей, и в этом случае в базе возникает электрическое поле, иаиравлеН1Юс к коллектору. Электрическое ноле, воз1Н1каюн1ее при высоком уровне инжекции, }ie .позволяет существенно улучшить динамические свойства транзистора, в то же время электрическое поле, возникающее в транзисторах с неоднородной базой, дает возможность улучишть эти свойства. Поэтому транзисторы с нсоД!!ороднон базой получили широкое раснространенис. В них дрейфовое поле в базе во М1Ю10 раз больше, чем рассчитанное ориентировочно выше [формула (2.2)], поэтому ток неосновных носителей в базе является нреимун1ССтвенно дрейфовым. По своему иринцину дейстаия такие транзистор!! назь!-ваются дрей(!ювьь\н1, хотя п них наряду с дрей()ОИЬ!мн п1К)!1е-самн протекают и дн(1)фузнон1Н.!е (см, гл. 4). Большинство соврсхкмннл.ч высокочастотных транзисторов работает на основе оннсанного вьнне дрейфового принципа. С точки зрения внешней структуры дро'кровые трапзпсюры пе отличаются от бездрейфовых, и рис. 2.2 мог бы бьггь 1]рнме;им1 и для изображения дрейфового транзистора. Технологическими методами получения неравномерного распределения и римессTi п базе являются методы прямой и обратной диффузии атомов прнмесечг По методу изготовления эти транзисторы называют диффузнон1н>1-мн **\ Исторически заслуга открытия и реализации принципа улучшения CBOIICTB транзистора за счет дре11фового ноля и базе нр1шадле-жит Кремеру и Ирли. Последующие главы посвящены анализу процессов в базовой области и в прилегающих к иен запирающих слоях в бездрейфовом (гл. 2 и 3) и дрейфовом (гл. 4) транзисторах. При этом главное внимание уделяется установлению связи между физическими процессами и вольт-амперными характеристиками транзисторной структуры между точками Е\ В\ С как в статическом (гл.2), так и в динамическом режиме (гл. 3). В гл. 5 обсужда- Иногда в таких случаях применяют термин квазинейтральный , подчеркивая тем самым приближенность степени компенсации объемного заряда доноров зарядом электронов. - Прим. перев. См. (Примечание на стр. 91. г ется вопрос о тех основных отличиях, которые следует ожидать между свойствами внутреннего и внешнего транзистора. Свойства реального транзистора отличаются от свойств модельного . Причины этого весьма разнообразны и частично совпадают с причинами различия свойств реального и адеального р-п перехода (см. § 1.4). Анализу влияния этих причин применительно к транзистору посвящена гл. 6, которая образует своеобразный связующий мост между физическими процессами в транзисторе и его техническими характеристиками. В ней рассмотрены многие технические вопросы, которые встречаются на практике ;и требуют изучения. В этой части рассматриваются, например, также эквивалентные схемы замещения транзистора, которые уже вследствие различия существующих методов изготовления и конструкций бывают довольно сложными и отличаются от эквивалентных схем модельного транзистора. 2.1. Распределение концентраций носителей в кристаллических областях бездрейфового транзистора. Режимы работы транзистора В равновесном состоянии во всех кристаллических областях транзистора выполняется закон действующих масс (рис. 2.4): пр = пг. Поэтому все равновесные концентрации основных {Ре,по,Рс) и неосновных {пе,Ро,пс) носителей можно отложить на графике с логарифмиче- Рнс, 2.4. Равновесное распределение концентраций ьюсите-лей заряда в бездрейфовом гранзисторе с резко несимметричными р~п переходами. ~ протяженности нейтральных областей эмиттера и коллектора соответственно. U7-ширина базы.  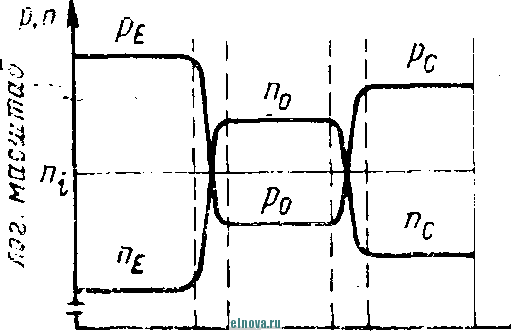 i x  ским масштабом по оси ординат, причем концентрация собственных .носителей щ представляется на этом графике как некая отсчетная линия. Величина концентраций основных носителей определяется уровнем легирования соответствующих областей кристалла. Поскольку база более высокоомная по сравнению с эмиттером (NaeNdo) и коллектором {Ndq<Nac)j то в структуре образуется два оезко несимметричных р~п перехода. При приложении выбранных независимо друг от друга напряжений к эмиттерному {U,,) и коллекторному (f/B ) переходам концентрации неосновных носителей на границах запираю цего слоя меняются: эмиттер О п{0) = п при X -/ при X-rrlnc PHne)--- Р^ при Л' = / с р{1п^)--- Р^ (2.3) коллектор при х~1 при х = 1 11{1рс) Формулы, описывающие распределение концентраций нзбыточшлх носителей заряда в кристаллических областях транзистора, могут быть получены из аналогичных соотношении, известных для рчг перехода [формула (1.29)]: для эмиттера п (е  п (2.4а) для коллектора п {х) - /г , = ;г,(е^---1)Х Xfsh Ln J (2.46) 1 -L для базы [см. уравнение (1.28)] Ро(е Ue,BIVt ) (si. !  (управляется эмиттером)   Х</ е) (2.4в) (управляется коллектором). Таким образом, график распределения концентраций носителей в базе можно представить себе как сумму двух графиков распределения: одного, связанного с напряжением иа эмиттере, другого - с напряжением на коллекторе. Зависимости (2.4) в рамках диффузионной теории определяют статические характеристики транзистора. При малой ширине базы (Ш<Ьр) что необходимо для достижения более высокого коэффициента инжекции. [см. формулу (1.45)], из общего уравнения (2.4в) путем разложения в ряд гиперболических функций можно получить линейную зависимость концентрации неосновных носителей в базе с координатой Р{) - Р, = Р{1пе)[ 1 р, = рЛх)А-р^ {X). (2.5) Распределение концентраций неосновных носителей в эмиттерной и коллекторной областях транзистора принципиально ничем не отличается от соответствующего распределения в одиночном р-п переходе. По-иио-му обстоит дело в базе, где закономерность распределения концентрации носителей можно представить себе как суперпозицию пяти функций: X i W S I - 1 + PqQ I sh (2.6) Особенно важную роль играют слагаемые 4 и 5, связанные с напряжениями иа запирающих слоях, посколь-7-1323 97 K> именно благодаря этим слагаемым получаются характерные для различных режимов работы транзистора законы распределения концентраций неосновных носителей, а следовательно, и токи в транзисторе (рис. 2.5). В зависимости от знака того или иного напряжения мо-рут иметь место четыре различных режима работы Запирающий слой эмиттеп  Запирающий слой 1 коллектора   Рп Г а) распределение концентраций те в различных режимах: - в Рис. 2.5. Качественное распределение концентраций неосновных носителей в бездренфовом р^п-р транзисторе (модуляция ширины запирающих слоев не учитывалась). областях транзистора при его рабо- ый ормальн. режим ~ ЖИМ {110),-----------режим насыщения ( /); б) составляющие концентрации неосновных носителей в базовой области в rn ответствии с уравнением (2.6): i - термодинамически равновесная к^ ? 2-концентрация в базе при приложении запирающего наХ^я к эмиттеру. j-to же самое при запирающем напряжеиии на кол5Х 4-концентрация дырок, инжеггироваиных из эмиттера. 5-koXhS дырок, инжектированных из коллектора. концентрация )Гкйорае леКо йзлиь, jyicoioicf- - >S вуяйь законом распределения концентраций [формула (2.6)]. Таблица 2.1 РЕЖИМЫ РАБОТЫ ТРАНЗИСТОРА Эмиттерный переход С д/ <о Коллекторный переход с*в' <2 Режим работы / режим отсечки На нормальное включение (активный режим) 116 инверсное включение (активный режим) / режим насыщения Примечание. Знаки стору. напряжений относятся к р-п-р транзн- Режим отсечки (I) (cut-off region) U Е'В и  с'в' Р^ больших отрицательных напряжениях t/,, . f/cs слагаемые 4 и 5 в уравнении (2.6) вообще исчезают, а слагаемые 1 и 3 становятся равными нулю на соответствующей границе базы. Таким образом, любой неосновной носитель, достигая границы запирающего слоя, мгновенно отсасывается из базы. Однако в базе непрерывно идет тепловая генерация электронно-дырочных пар. Генерируемые дырки под действием градиента концентрации движутся в направлении запирающих слоев, обеспечивая тем самым непрерывное протекание тока через переходы. В итоге в базе устанавливается распределение концентрации неосновных носителей, описываемое суммой первых трех слагаемых в уравнении (2.6), В уС7-областях транзистора протекают дырочные дрейфовые токи. Избыток электронов, появляющихся в базе вследствие тепловой генерации, непрерывно выводится из базы через базовый контакт, так что в базе сохраняется условие электронейтральности. Одновременно в базу через запирающие слои втекают электроны (хотя и в малом количестве), поставляемые электронными диффузионными токами из обеих р-областей (эмиттера и коллектора) [уравнения (2.4а) и (2.46)]. Обычно эти электронные компоненты токов малы по сравнению с дырочными. Так как оба р-п пере- 7* 99 1 2 3 4 5 6 7 ... 24 |
|||||||||||||||||